HORIBA堀场制作所 基于光发射光谱和 MWL 干涉测量法的健康监测仪EV 2.0 Spectrometer
HORIBA堀场制作所 基于光发射光谱和 MWL 干涉测量法的健康监测仪EV 2.0 Spectrometer
HORIBA堀场制作所 基于光发射光谱和 MWL 干涉测量法的健康监测仪EV 2.0 Spectrometer
更多详情咨询:13024103468 刘经理
为满足使用干法蚀刻、等离子清洗和等离子体增强化学气相沉积法(PECVD)加工半导体、照明设备、汽车部件、平面显示屏、MEMS 传感器、存储芯片和逻辑电子产品的新要求,HORIBA 推出了一款传感器,专门用于先进终点控制、故障检测和腔室健康监测。
EV 2.0 是一款高性能光谱仪,专为各种半导体原始设备制造商(OEM)和最终用户应用定制,包括具有自动终点配方创建功能的工艺工程,以及执行完整终点和过程质量管理的机上处理。
EV 2.0 专用于单腔室或多腔室配置下的光发射光谱(OES)或多波长干涉测量(INT)终点过程实时监测。
EV 2.0 属于 EV 产品家族,引入了模块化设计。EV 2.0 适用于现场监测等离子体健康、工艺稳定性、泄漏、电弧放电和异常等离子体性能,以及检测 OES 或 INT 配置中的终点。
一般特征
用于实时监测和终点检测的 Sigma_P
Sigma_P© 软件允许快速配置配方,然后创建可靠的终点检测:
通过基于 Windows 10 的软件平台,直观的用户交互设计允许处理光谱或直接处理波长。该软件包含一个具有等离子体发射波长的开放库。
用户可使用配方编辑器构建有效的配方,包括多波长算法、信号算法和过滤,以及终点/健康监测条件和决策,并集成在线帮助。
同一界面最多可显示 8 条曲线,同时监测特定种演变、终点和腔室健康。
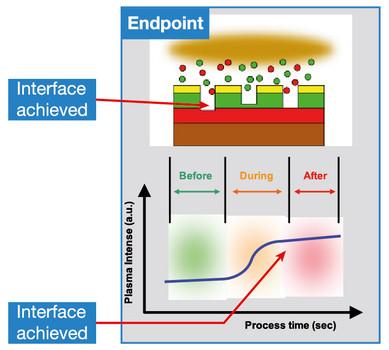
配方管理
统一的设计概念允许用户在一个流畅且易用的类似 Excel 的配方编辑器中设置配方。
通过 Sigma_P 软件扩展设置功能,纳入多个用于特殊信号检测和差信噪比信号检测的兼容算法,并且始终可以扩展。

SQL 管理
腔室数据库、工具数据库嵌入在传感器附近,可由操作人员、配方、统计人员、HM/APC(健康监测/先进制程控制)服务器、远程制程工程师办公室在线访问。
活动配方管理器
扩展允许批间、晶圆对晶圆、批对批、腔室对腔室的数据交换,以强化生产控制。
原位统计制程控制
统计引擎允许配方自我计算生产指标和默认值,既可由直接用户触发,也可从主机或工程师工作台触发。

自动化数据链路管理器
使用中间件设计接口室、设备主机、晶圆厂主机、晶圆厂服务器的灵活性:远程控制(RS 232、TCP/IP、PIO)、SECS、HSMS、Fab LAN、Fab e-mailing 和其他协议。
先进算法管理器
强大的外部数学工具与本地配方数学公式编辑器和原位数学计算器的结合。
分布式和配置
得益于在仪器集群化方面的丰富经验,这一新概念允许配置从独立工程、集成腔室控制器直至完整多腔室的仪器。
健康监测和先进制程控制
根据 HM/APC 视觉、技术和工具,开放性设计可整合基于规则和配方集成的用户场景。

OES 配方设计器 2.0
为简化 OES 工程流程,无监督 AI 机器学习可简化 OES 工程并创建强终点配方。
算法实时处理先前选择的选定波长,然后计算(通过最小化拟合)临时断裂位置和断裂强度。断裂点代表适合的残差方差时的统计拟合。当断裂强度大于预定阈值时,达到终点。

制程工程师只需管理 4 个参数:时间窗口、波长范围、断裂方向(如种显示则向上,如种消失则向下)和阈值。
然后,配方设计器©允许自动提取包含原谱、等离子体变化特征(如实现的接口、杂质检测、发现的终点等)的相关波长, …
随后,一个终点配方被自动构建并一键传送到 Sigma_P。若无该易用且功能强大的工具,我们将无法接近复杂的终点!
EV 2.0 电脑应用
一般特征
对于基于 OES(光发射光谱)或干涉测量(使用宽谱闪光灯光源的激光或多波长)的 CCD(电荷耦合器件),终点检测主要包括三个步骤:
选择携带过渡信息(接口检测)或厚度/深度/剩余厚度信息的相关波长;
实时数据过滤(广义上)和终点指示器构建;
一系列测试让算法直面生产波动的现实。
为满足这些新要求,HORIBA 开发了基于OES或干涉测量的新型传感器(硬件和软件),执行适用于所有蚀刻机的终点检测、故障检测、腔室健康监测和先进制程控制(APC),以帮助工程师和晶圆厂管理当前和未来的产品和技术。
光发射光谱:OES
EV 2.0 充分利用了 OES 技术
EV 2.0 使用光发射光谱(OES),对在紫外可见近红外区域具有光跃迁的原子和离子发射的光谱进行研究。OES 作为一种多用途的定性工具,是制程工程师的手段之一,无任何侵入性的等离子体微扰:
凭借 EV 2.0,HORIBA 为以下行业提供了从研发到工业应用的多功能解决方案:
等离子干法蚀刻和沉积的一般监测:数据收集、分析、比较(使用内部发射库)、制程识别、一致性控制
清洗过程
腔室健康监测:腔室鉴定试验、调节、匹配和故障排除、腔室气体纯度控制和泄漏检测、预防性维护后检查、故障分析…
先进终点制程控制:全自动终点/批间控制/故障检测分类/健康监测系统,以提高半导体制造的成品率和生产率。
终点
晶圆批间控制
接口检测
制程一致性
低开放区域
尽可能减少过蚀刻,保护晶圆免受蚀刻不全
生产再现性
质量:成品率和通过量
腔室健康
湿法清洗周期中的腔室/制程稳定性控制
等离子体光谱监测
腔室指纹图谱、管道、定量比较的参考(库)
工艺漂移、趋势分析
超大信号检测
预防性维护
减少工具停机时间
HORIBA 为 WIN10 PRO、64 位电脑提供专用于 OES 监测和终点检测的 HORIBA 软件

关键附加组件:配方设计器2.0,以简化终点检测和工艺流程

干涉测量:INT
EV 2.0 INT 提供实时准确可靠的厚度/深度信息
除等离子体外,样品信息也很复杂。EV 2.0 INT(LEM-CT)安装在任何可直接俯视晶圆的处理室上,可获得光学半透明多层结构的局部信息。可实时监测蚀刻速率和蚀刻厚度,为各制程提供增强的工艺控制。此外,接口可通过其反射率的变化来检测。
由于采用干涉测量技术,EV 2.0 INT 非常适合蚀刻/沉积速率监测和终点检测,可对条纹计数、膜厚、沟槽深度、接口等进行高精度检测…